-


-


-

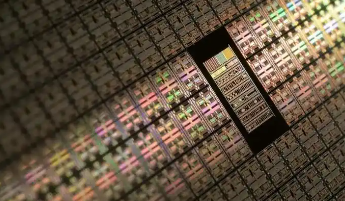
-

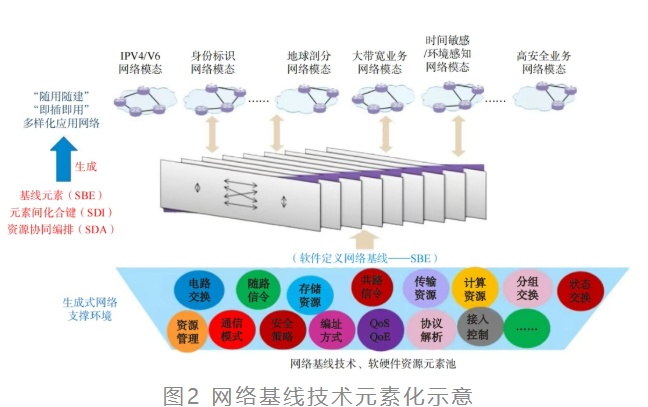 AI4E如何重构数字生态系统网络发展范式? 2025-07-21 人工智能作为当今时代最具变革性的技术力量,正以前所未有的速度推动经济社会发展。人工智能不仅带来AI for Science(AI4S)的科学研究新范式,更带来AI for Engineering(AI4E)的工程科技范式变革。《科技导报》邀请邬江兴院士团队撰文,系统阐述了AI4E驱动数字生态系统网络发展范式的转型动因、机理与实践路径,并指出传统数字生态系统网络发展范式面临“刚性架构与场景多样化”的根本矛盾,亟需以“超融合、高可信、一体化”为目标进行重构。面对扑面而来的AI4E浪潮,AI4E范式将为中国在全球数字生态系统网络技术版图重构中抢占发展定义权提供“换道超车”的难得机遇。 了解详情了解详情
AI4E如何重构数字生态系统网络发展范式? 2025-07-21 人工智能作为当今时代最具变革性的技术力量,正以前所未有的速度推动经济社会发展。人工智能不仅带来AI for Science(AI4S)的科学研究新范式,更带来AI for Engineering(AI4E)的工程科技范式变革。《科技导报》邀请邬江兴院士团队撰文,系统阐述了AI4E驱动数字生态系统网络发展范式的转型动因、机理与实践路径,并指出传统数字生态系统网络发展范式面临“刚性架构与场景多样化”的根本矛盾,亟需以“超融合、高可信、一体化”为目标进行重构。面对扑面而来的AI4E浪潮,AI4E范式将为中国在全球数字生态系统网络技术版图重构中抢占发展定义权提供“换道超车”的难得机遇。 了解详情了解详情 -


-

 为何SDSoW是智能时代的标志性芯物种?——NDSC副主任刘勤让主讲,晶上系统公开课第3期丨直播预约 2025-08-18 当GPU困于算力密度、TPU受限于专用场景,Loihi与SpiNNaker难破规模瓶颈,智能时代正呼唤全新“芯物种”。#软件定义晶上系统 (SDSoW)以介观尺度架构革新,弱化传统计算的集中/分布式矛盾,让局部与全局协同从“对立”转向“动态调优”。它通过晶圆级高密度集成,将通信时延从宏观微秒级压降至纳秒级,以“低频率并行+软件定义资源”破解功耗与算力的两难,为AI提供“弹性算力、高效能效”支撑。 作为“介观智能计算”新领域的开创者,#SDSoW 既是突破冯·诺依曼瓶颈的工程载体,也是承载类脑神经网络的基础设施,在算力爆炸与能耗趋紧的今天,它不仅是技术范式升级的引擎,更是连接工程实践与智能理论的关键桥梁,堪称智能时代不可或缺的“芯物种”。 了解详情了解详情
为何SDSoW是智能时代的标志性芯物种?——NDSC副主任刘勤让主讲,晶上系统公开课第3期丨直播预约 2025-08-18 当GPU困于算力密度、TPU受限于专用场景,Loihi与SpiNNaker难破规模瓶颈,智能时代正呼唤全新“芯物种”。#软件定义晶上系统 (SDSoW)以介观尺度架构革新,弱化传统计算的集中/分布式矛盾,让局部与全局协同从“对立”转向“动态调优”。它通过晶圆级高密度集成,将通信时延从宏观微秒级压降至纳秒级,以“低频率并行+软件定义资源”破解功耗与算力的两难,为AI提供“弹性算力、高效能效”支撑。 作为“介观智能计算”新领域的开创者,#SDSoW 既是突破冯·诺依曼瓶颈的工程载体,也是承载类脑神经网络的基础设施,在算力爆炸与能耗趋紧的今天,它不仅是技术范式升级的引擎,更是连接工程实践与智能理论的关键桥梁,堪称智能时代不可或缺的“芯物种”。 了解详情了解详情 -

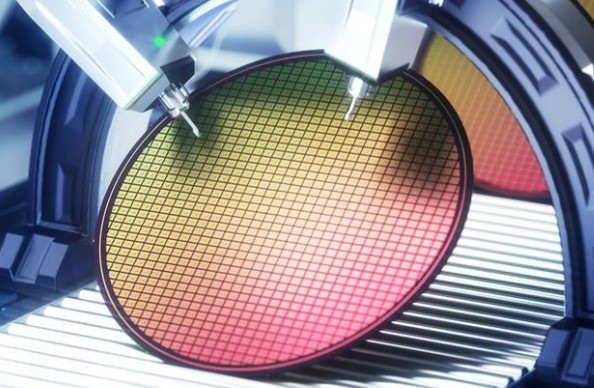
-

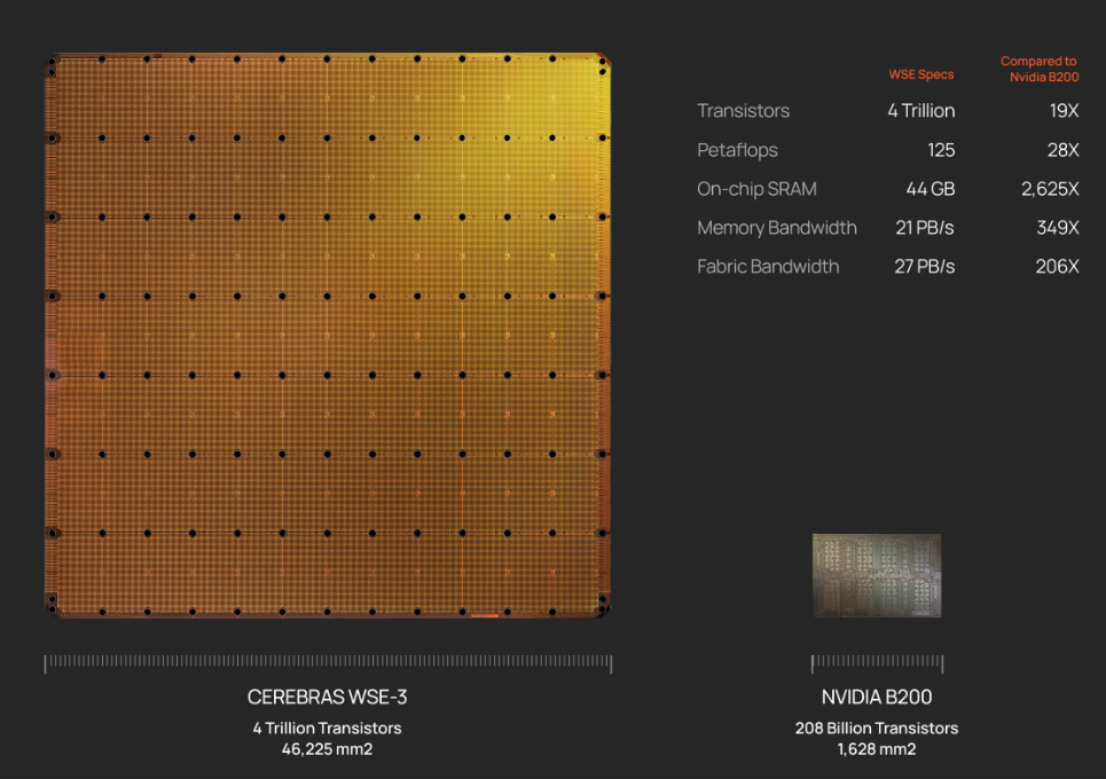
-


-












